 2025.06.20
2025.06.20PCB核心材料铜易氧化,影响可焊性与电气性能,而表面处理旨在为铜表面构建防护层,确保其稳定运行。目前,热风整平、有机涂覆、化学镀镍/浸金等工艺应用广泛,且各有优劣与适用场景。
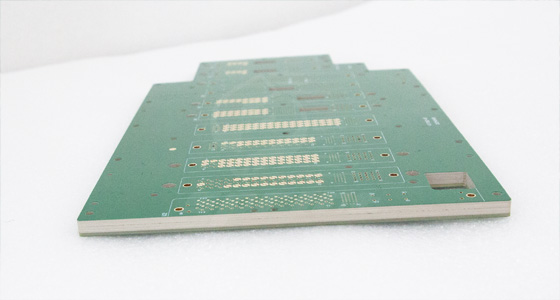
热风整平通过在PCB表面涂覆熔融锡铅焊料,利用加热压缩空气整平,形成抗氧化且可焊的涂覆层,过程中会生成1-2mil厚的铜锡金属间化合物。该工艺分垂直式和水平式,后者因镀层均匀、易自动化生产更受青睐。
其流程包含微蚀、预热、涂覆助焊剂、喷锡和清洗。此工艺成本低、可焊性好、工艺成熟,但存在表面平整度差、易产生锡珠、环保性欠佳等问题,适用于对成本敏感、平整度和精细焊接要求不高的消费电子与工业控制领域,如家电控制板。
OSP在裸铜表面化学生成有机皮膜,该膜常态下防氧化,焊接时可被助焊剂清除。如今多使用苯并咪唑,为应对多次回流焊,需构建多层有机涂覆层。工艺流程涵盖脱脂、微蚀、酸洗、清洗、有机涂覆和二次清洗,过程控制相对容易。
OSP工艺简单、成本低,约25%-30%的PCB会采用且占比上升,具备裸铜焊接优势。不过,其易受酸和湿度影响,二次回流焊效果差,存放和使用时间受限,测试和组装存在一定困难。适用于对表面连接功能和储存期要求不高的场景,如电视机用PCB、高密度芯片封装板等。
ENIG在铜面形成镍金合金层,能长期保护PCB,相比OSP,其电性能和环境耐受性更佳。镀镍可阻止金铜扩散,还能控制高温下Z方向膨胀,利于无铅焊接。工艺涉及脱酸洗清洁、微蚀、预浸、活化、化学镀镍和化学浸金,过程复杂,控制难度大。
该工艺不易氧化、可长期存放、表面平整,适合焊接细间隙引脚,可承受多次回流焊,能作为COB打线基材。但成本高、焊接强度弱、易出现黑盘问题,长期可靠性存疑。主要用于对表面连接功能要求高、储存期长的领域,如手机按键区、路由器连接区等,目前约10%-20%的PCB会使用。
沉银工艺介于OSP和ENIG之间,简单快速,虽不能形成厚防护层,但能保持良好电性能和可焊性,不过表面会失去光泽,且物理强度差。它通过置换反应形成亚微米级纯银涂覆层,有时添加有机物防银腐蚀和迁移。
沉银工艺简便,电性能和可焊性良好,储存性佳,但不适用于对机械强度要求高的场景,常用于对电性能、可焊性要求高且成本敏感的领域,如部分消费电子和通信设备电路板。
因焊料多以锡为基础,沉锡工艺理论前景广阔。曾因锡须和锡迁移问题受限,后通过添加有机添加剂解决,使其具备良好热稳定性和可焊性,能形成平坦的铜锡金属间化合物,避免热风整平的平坦性问题,且无金属间扩散问题。不过,沉锡板存储期短,组装需按顺序操作。适用于对可焊性、平整度要求高且能快速组装的场景,如中低端电子产品。
此外,电镀镍金作为早期工艺,先镀镍防金铜扩散,再镀金,分软金和硬金,分别用于芯片打金线和非焊接电性互连;化学镀钯工艺与化学镀镍相似,虽焊接可靠性和热稳定性好,但因钯为贵金属,成本较高。

 2025.06.20
2025.06.20
 2025.06.20
2025.06.20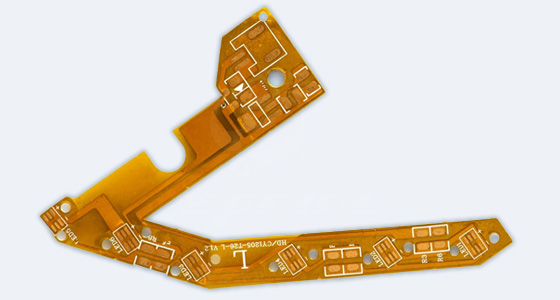
 2025.06.20
2025.06.20
采购咨询,获取商机
 小红书
小红书

 公众号
公众号

 抖音
抖音

 视频号
视频号

 TOP
TOP