 2025.06.20
2025.06.20高阶HDI板是高密度互联技术发展的进阶产物,在电子设备集成度持续提升的需求下,成为支撑高端电子系统的关键基础部件。其结构设计与制造工艺均围绕高密度信号传输与微型化安装需求展开,区别于常规电路板的技术特性,使其在精密电子领域具有不可替代的作用。
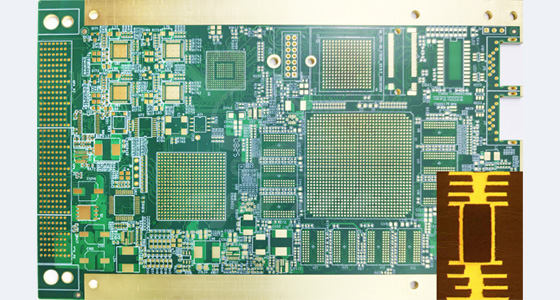
高阶HDI板的核心特征在于其微孔结构。此类微孔采用激光直接钻孔工艺形成,孔壁粗糙度控制在较低水平,确保了孔壁与镀层的结合强度。与传统机械钻孔形成的通孔不同,高阶HDI板的微孔多为盲孔或埋孔结构,仅实现特定线路层之间的互联,避免了通孔对板面空间的占用。
微孔的分布呈现阵列化特征,孔中心距较小,配合精细线路设计,显著提升了单位面积内的互联密度。在多层结构中,微孔通过阶梯式或交错式排布,实现不同层级线路的立体互联,为高密度元件布局提供了结构基础。
线路密度是高阶HDI板的关键技术指标。该参数的实现依赖于高精度光刻技术与蚀刻工艺,线路边缘垂直度偏差较小,确保了信号传输的阻抗一致性。
线路布局采用差分对设计为主,针对高速信号传输需求,设置特定的阻抗控制线路,特征阻抗偏差控制在较小范围。接地平面与信号层的交替排布,有效降低了线路间的串扰,满足高频信号传输的电磁兼容性要求。
高阶HDI板采用多层叠合结构,层数较多。叠层布局遵循信号完整性原则,电源层与接地层采用对称分布,形成稳定的电源分配网络,电源平面阻抗控制在较低水平。
层间绝缘材料选用低介电常数的改性环氧树脂或聚酰亚胺材料,介电损耗在高频下处于较低水平,有效降低了高频信号的传输损耗。层压工艺采用分步压合方式,每层压合后的厚度偏差控制在较小范围,确保整体厚度精度。
基材方面,高阶HDI板突破了传统FR-4的限制,主流采用无卤阻燃型复合材料,玻璃化转变温度较高,热膨胀系数在Z轴方向控制在较低水平,满足回流焊过程中的热稳定性要求。
导电材料采用高纯度的电解铜箔,表面经粗化处理后形成微米级凹凸结构,增强与基材的结合力。对于高频应用场景,可选用经退火处理的超低轮廓铜箔,减少信号传输过程中的趋肤效应损耗。
表面处理工艺需兼顾焊接性能与长期可靠性,主流采用化学沉金工艺,金层与底层镍层厚度控制在合适范围,镍层纯度较高,确保焊点的抗腐蚀性能与可焊性。
阻焊层采用感光型环氧树脂油墨,厚度控制在合适范围,分辨率较高,能够精准覆盖线路区域并露出焊盘。阻焊层需通过温度循环测试无开裂现象,确保在恶劣环境下的防护性能。
高阶HDI板通过微孔互联、高密度线路、多层结构等技术特征,实现了电子系统的微型化与高性能化。其制造过程涉及材料科学、精密加工、测试分析等多学科技术融合,工艺合格率处于较高水平,成为5G通信、人工智能、医疗电子等高端领域的核心基础部件,推动着电子设备向高密度、高频化、低功耗方向发展。

 2025.06.20
2025.06.20
 2025.06.20
2025.06.20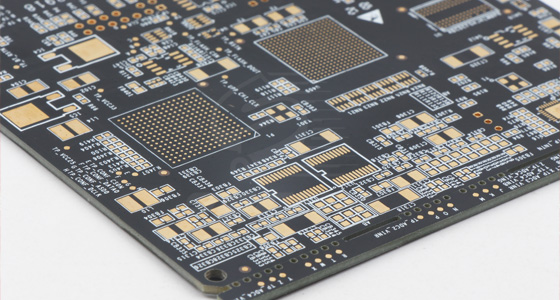
 2025.06.20
2025.06.20
采购咨询,获取商机
 小红书
小红书

 公众号
公众号

 抖音
抖音

 视频号
视频号

 TOP
TOP